摘要:乐见”苹果“单挑”英特尔“,瞧,科技进步就是这么“打”出来的。
自苹果M1芯片发布以来,可谓是一石激起千层浪,在性能方面完全碾压挤牙膏多年的英特尔处理器。
有媒体报道称,苹果将“乘胜追击”,会在在未来几年内推出性能更强的第2代和第3代Apple Silicon芯片,其中最快于2023年推出由台积电代工的3nm Mac芯片,也就是第三代Apple Silicon芯片,其内部代号分别为“Ibiza”、“Lobos”以及“Palma”,这些芯片最多将采用四个Die的设计,最高集成40核 CPU。
这也意味着明年苹果推出的二代Apple Silicon芯片会和M1一样,采用5nm的制程,因此也可以推断出该芯片较当前的M1系列在性能(或指单个核心)和能效方面的提升相对有限。

考虑到台积电当前在3nm工艺上遇到了挑战,保守估计其在明年下半年才能实现量产,此番苹果也是为了保证产品的稳定性。
不过,苹果似乎提出了新的解决方案,他们计划在二代芯片上使用两个单芯片的组合,从而实现更多核的计算能力。举个例子,在对性能要求较高的台式Mac上,苹果可能会以现有的M1 Pro/M1 Max为基础扩展出两个Die的芯片,即本质上形成双M1 Max设计,从而使其(多核)性能实现翻倍。
这里的Die指的是芯片未封装前的晶粒,是从硅晶元(Wafer)上用激光切割而成的小片(Die),每一个Die就是一个独立的功能芯片,它的里面又细分为几个小单元,每个小单元称为一个chip。我们平常在PCB板子上看到的“芯片”其实就是将Die封装而成的。
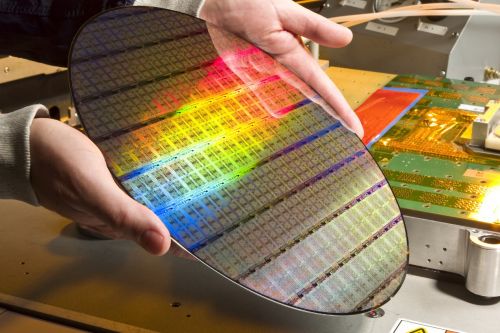
至于为什么要封装,则是因为它在空气中会与各种杂质接触后产生电路腐蚀,影响性能。而且没有封装的芯片,很容易在操作过程中产生划痕。当Die被封装在一个支撑物之内,这个封装可以防止物理损坏(如碰撞和划伤)以及化学腐蚀,并提供对外连接的引脚,这样就便于将芯片安装在PCB里。
回到苹果芯片,之前也有业内人士爆料苹果的最高端的芯片或将采用四个 Die 的设计,综上可推测未来的二代和三代Apple Silicon芯片设计都是在M1基础上的排列组合,通过“堆叠”来获得更高的处理性能。
苹果当前已发布的M1芯片的CPU配备 8 核中央处理器,其中包括4个高性能核心和4个高能效核心。而M1 Pro的CPU最高拥有 8 个性能核心与 2 个效能核心,CPU性能比 M1 最多快 70%,GPU 性能最高提升 2 倍。M1 Max的CPU核心还是八大二小共10个,不过GPU图形核心再次翻番到32个,性能也全部翻倍或者接近翻倍。
由以上参数可见,M1系列的CPU核心最高为10核,如果二代而三代芯片是在此基础上迭代,2年后芯片最高可以拥有40核也在常理之中,再加上台积电的3nm工艺,个人PC的处理性能或许会在这几年内得到质的飞跃。苹果迈出的成功的一步,也让爱挤牙膏的老朋友英特尔压力巨大。
作为消费者,也可以乐见未来个人PC的无限可能。









